ECRCVD
Electron Cyclotron Resonance Chemical Vapour Deposition (ECR-CVD)
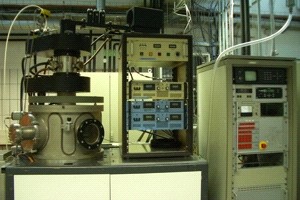
ECR-CVD by ASTeX
Die zwei plasma-unterstützten electron cyclotron resonance chemical vapour deposition Systeme (ECR-CVD) der Firma ASTeX (Applied Science and Technology) bestehen jeweils aus folgenden Hauptelementen: 2.45 GHz Mikrowellen-Generator, zwei Magnete, wassergekühlte ECR-Anregungskammer, Niedrigdruck-Arbeitskammer, Substrat-Tisch, Substrat-Heizer.
Die ECR-Quelle ist in der Lage, ein gleichförmig verteiltes Plasma mit einer hohen Ionendichte zu generieren. In Regionen der Anregungskammer, in denen die Feldstärke ca. 875 Gauss beträgt findet Elektronen-Zyklotron-Resonanz statt. Hierdurch können die freien Elektronen im Plasma effizient die Mikrowellenenergie absorbieren, die anschließend für das Ionisieren der neutralen Spezies durch Kollisionen dient. Auf diesem Wege wird ein Plasma produziert, welches eine Elektronendichte von über 1012e/cm3 und eine Ionenstromdichte größer als 100mA/cm2 aufweist. Eine größere Ionenstromdichte führt zu einem effektiveren Aufbrechen der chemischen Bindungen des Reaktionsgases.
Die ECR-CVD-Anlagen werden am Lehrstuhl für das Abscheiden verschiedenster Schichten verwendet, z.B. Diamant, Metall, Oxid, carbon fibres oder nanotubes, DLC etc. Die im ECR-Plasma vorliegende hohe Ionenstromdichte und Elektronentemperatur erlaubt es, bei relativ niedrigen Abscheidungstemperaturen und –drücken (10-4-10-2 mbar) eine hohe Abscheidungsrate zu erreichen. Die Prozessparameter minimieren zudem Schäden und Kontaminationen des Substrates, woraus eine geringere Defektdichte in der Schicht und eine geringere Grenzflächenschädigung resultieren. Die ECR-CVD-Reaktoren arbeiten mit einer großen Anzahl an inerten und reaktiven Prozess-Gasen wie z.B. CH4, N2, H2, Ar, etc.
